曾经有个同学写的论文,通过TEM图像统计,发现在金属样品A中析出相密度只有样品B中的70%,他认为这是导致材料性能不同的重要原因。但是却在论文审稿时被一棍子打死......Why?
对于块体材料,TEM、STEM与SEM(二次电子像)最大的区别在于TEM获取信息时电子束要穿透样品,因此样品厚度必须要考虑。上面那个例子中,如果样品A的观测区域厚度是70nm而样品B是100nm,那么二者的析出相密度实质上是没有区别的。
大量新材料的研制开发以及性能特征评估和控制等都需要在微米、纳米尺度上对其微观组织特征进行分析测定,直接和准确地测量TEM试样的厚度对于TEM分析的许多方面都是至关重要的,例如定量统计二维投影特征的实际分布,修正试样内部吸收的X射线强度,X射线空间分辨率的确定,以及具有合理峰背比的EELS数据的获得等。
污染点分离法其实就是简单的几何法,使TEM样品的上下表面各有一个污染点,试样水平时二者重合,聚焦移至中央,然后再转过一个角度(沿A或B)使二者分离,根据测量转过的角度以几何方法计算样品厚度。
此方法有多种变种,比如使用贯穿样品上下表面的晶界等特征作为标记物,或者在一些原子序数较低的样品中通过汇聚电子束在样品中人为制造一个贯穿样品的污染点,然后再测量。该方法原理简单,可用于晶体和非晶样品,但实际上采用这一方式的并不多。
会聚束电子衍射(Convergent beam electron diffraction, CBED):应用会聚的电子束进行衍射的技术,由于入射电子束的孔径角较大(α通常大于10-3 rad,较大C2光阑与较强C1强度,相机长度L<500mm),导致衍射花样由具有一定尺寸的衍射圆盘与透射圆盘组成,在衍射盘内出现条纹衬度。

当正好在一个正带轴上时,未折射的透射光束(000)盘通常包含同心的漫射条纹,称为Kossel-Möllenstedt(K-M)条纹。衍射图案中的反射分成了几个区域,称为Laue区。中心区被称为零阶Laue区,ZOLZ。第一环被称为一阶劳厄区,FOLZ,以此类推。一阶、二阶、三阶等被统称为高阶劳厄区,HOLZ。因为透射盘中狭窄的、黑暗的直线与衍射成HOLZ反射有关,所以它们被称为HOLZ线。
硅[111]带轴的CBED花样,可以看到衍射盘中的动力学衬度以及弥散的菊池带和明锐的暗HOLZ线。
厚度每增加一个消光距离,K-M条纹的数量就增加一个。然而,厚度测量不是在正带轴条件下进行的,而是在只有一个加强的(hkl)反射的双光束条件下进行的。在双束模式下,TEM入射电子的能量可以近似认为由透射束和最强的衍射束组成。此方法基于衍射光束的强度随厚度的变化,被称为Pendellösung 条纹,测量的试样应该比一个消光距离更厚。双光束条件下,CBED盘将包含平行的而不是同心的条纹。中央明亮的条纹符合准确的布拉格条件。hkl衍射盘内第i级暗条纹到中心亮纹的距离为Δθi(mm) ,从条纹间距可以确定第i级暗条纹对精确布拉格条件的偏差si(nm),根据

这种方法已经被广泛使用,提供了优于2%的精度。通过CBED得到的厚度只包括晶体材料的厚度,所以它不涉及TEM薄膜上的非晶层。例如,不包括由FIB损伤产生的非晶层。此外,这种对某些晶格参数很大的材料应用非常有限,比如大多数矿物标本,因为很难从小的倒数晶格尺寸中获得衍射盘和真正的 "双光束 "条件。这种方法已经被广泛使用,提供了优于2%的精度。通过CBED得到的厚度只包括晶体材料的厚度,所以它不涉及TEM薄膜上的非晶层。例如,不包括由FIB损伤产生的非晶层。此外,这种对某些晶格参数很大的材料应用非常有限,比如大多数矿物标本,因为很难从小的倒数晶格尺寸中获得衍射盘和真正的 "双光束 "条件。双光束倾转后厚度修正:t0=t cosφ cosφ =cosA cosB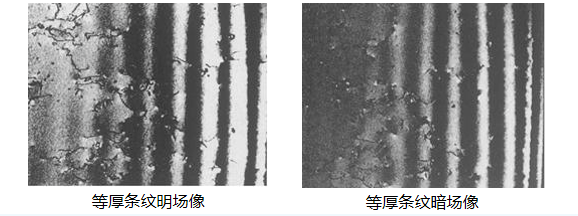
由于衍射束和透射束是互补的,因此在TEM明场像和暗场像中都能观察到等厚条纹,而且二者的衬度是相反的。在明场像中:样品厚度满足 t=(n-1/2)ξg时透射束强度最低,表现为暗纹,在t=nξg时则是亮纹。在暗场像中衬度相反。(n为整数,从1开始取)。这里不可避免地要讨论ξg。
等厚条纹法是常用的方法,使用等厚条纹法测量TEM样品厚度时需要进入双束模式。在双束条件下样品的衬度会随厚度增大呈现周期性的明暗变化,称为等厚条纹。条纹变化的周期与厚度相关,一个周期对应的厚度称为消光距离。显然,只要我们找到第一条暗纹(亮纹),就能通过条纹的数量来估测厚度。这个方法的优点是不需要电镜安装其他硬件,也不需要调整太多的参数,缺点是测量精度较低,非常依赖于实验人员的判断。
EELS谱(电子能量损失谱)可以分为三部分:能量损失大于50 eV的称为Core-Loss,Core-Loss EELS可以用来做原子级的元素Mapping,反馈元素的种类,价态,成键态和能态密度等信息;小于50 eV的则称为Low-Loss,Low-Loss EELS最被熟知的应用是测量薄膜厚度;没有能量损失的做 Zero-Loss Peak(ZLP),其半高宽常用来表示EELS能峰叫量分辨率。
由于非弹性散射随着样品厚度的增加而增多,所以通过计算损失谱总积分强度和损失谱中零损失峰的积分强度可以计算出样品厚度:
此方法适用于无定形,多晶和单晶材料的厚度估算,一般认为准确度在10%以内。由于表面激发随着样品变薄而升高,因此对于过薄的样品一般会高估样品厚度。对于过厚的样品,弹性散射强度和非弹性散射角度分布的变化也会导致误差变大。采用此方法计算厚度时,一般以0.2<t/λ<5为宜总结
1、几何法适用于晶体与非晶体,通用性高,但操作上存在不确定性。
2、CBED法适用于晶体材料,操作较复杂,精度很高,需要知道材料的晶体学信息。3、等厚条纹法适用于晶体材料,操作简单,精度较低,需要知道材料的晶体学信息。
4、EELS法操作简单,可靠性及精度高,需要硬件支持,适用于晶体和非晶体,但是可能会引入上下表面可能的非晶损伤/contamination层的厚度。